Технология фокусированных ионных пучков (ФИП), развитая на базе двулучевых систем, совмещающих растровую электронную микроскопию с ионным пучком, широко применяется в современных полупроводниковых технологиях, научных исследованиях, а также для решения прикладных задач препарирования образцов для электронной микроскопии. Данная технология обеспечивает возможность локального прецизионного травления и ионно-стимулированного осаждения различных материалов (металлов, диэлектриков). Высокая локальность модификации поверхности подложек сфокусированным пучком высокоэнергетичных ионов используется для создания элементов микромеханики и микроэлектромеханических систем (MEMS).
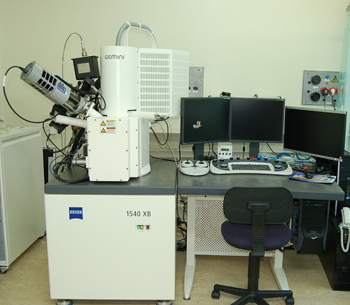
- Марка — CROSS BEAM 1540XB.
- Производитель/страна — Zeiss, Германия.
- Технические характеристики:
- Характеристики электронной пушки:
- Рабочее расстояние — 0-45 мм.
- Разрешение — 1,1 нм @ 20 кВ,
2,5 нм @ 1 кВ. - Увеличение — 20x - 900kx.
- Ток пучка — 4 пA - 20 нA.
- Ускоряющее напряжение — 0,1 - 30 кВ.
- Тип катода — Thermal field emission type.
- Давление в пушке < 1×10-9 Торр.
- Характеристики ионной пушки (Ga+):
- Рабочее расстояние — 5 мм.
- Разрешение — 5 нм достижимо.
- Увеличение — 600x - 500kx.
- Ток пучка — 1 пA - 50 нA.
- Ускоряющее напряжение — 3 - 30 кВ.
- Тип катода — Ga liquid metal ion source (LMIS).
- Давление в пушке < 1×10-9 Торр.
- EDX анализ
- Приставка для электронной литографии
- Система напуска газов (до 5 газов для селективного травления, глубокого травления, осаждения металлов и диэлектриков).
- Давление в рабочей камере < 1×10-6 Торр.
- Наклон образца до 54°.
- Детекторы:
- In-lens: Annular type — внутрилинзовый детектор.
- Chamber: TV.
- SE-детектор вторичных электронов.
- Характеристики электронной пушки:
- Местонахождение в ЦКП — Отделение ионной литографии и Отделение cканирующей электронной микроскопии, к. 108.
- Год модернизации — 2013.
- Балансовая стоимость — 27797 тыс. руб.
- Предоставляемые услуги:
- Cоздание структур пониженной размерности для наноэлектроники и наномеханики на основе комплекса литографических методов, включающих электронную, ионно-лучевую и зондовую литографию.
- Проведение измерений линейных размеров элементов структур микро- и нанорельефа поверхности твердотельных материалов и биологических объектов в нанометровом диапазоне.
- Исследование морфологии и структуры поверхности твердотельных структур и оперативный контроль атомарных поверхностей методами сканирующей туннельной, атомно-силовой и электронной микроскопии.
- Используемые методики:
- Методика количественного морфологического анализа и измерений линейных размеров микрорельефа поверхности твердотельных структур с применением сканирующего электронного микроскопа.
- Методика структурирования поверхностей различных материалов под воздействием ионного пучка.
- Методика формирования ионным пучком из образцов ламелей (тонких срезов) для исследования методом просвечивающей электронной микроскопии.






